
Главная страница Случайная лекция

Мы поможем в написании ваших работ!
Порталы:
БиологияВойнаГеографияИнформатикаИскусствоИсторияКультураЛингвистикаМатематикаМедицинаОхрана трудаПолитикаПравоПсихологияРелигияТехникаФизикаФилософияЭкономика

Мы поможем в написании ваших работ!
Литографические методы в микроэлектронике
1. Введение
Технология осаждения тонких пленок позволяет с высокой точностью, например, до 10 нм, выдерживать размер прибора в одном измерении, перпендикулярном плоскости подложки. Формирование с такой же точностью рисунка на плоскости, т.е. в двух других измерениях, значительно сложнее. Оно обычно осуществляется с помощью процесса литографии, появившегося на основе технологии контактной печати. Развитие микроэлектроники происходит в направлении усложнения схем и уменьшения размеров рисунка, в настоящее время рассматривается возможность получения линий шириной 0,5 мкм с допусками в 0,1 мкм. Для выполнения этих требований необходима разработка систем формирования рисунка и литографического процесса с очень высокой разрешающей способностью.
Рисунок формируется экспонированием соответствующих участков тонкого слоя резистивного материала, нанесенного на пластину, светом, рентгеновским излучением или электронным пучком с последующим проявлением скрытого изображения. 3 зависимости от вида используемого излучения и типа резиста литография может быть оптической (фото), рентгеновской, электронно-лучевой или ионно-лучевой.
Процесс оптической литографии обычно начинается с машинного проектирования топологии рисунка с последующим фотоуменьшением (редуцированием) его линейных размеров. Уменьшенная в 2-10 раз копия, или сетчатый шаблон, непосредственно используется при получении изображения методом контактной печати. В пошаговых системах редуцирования и формирования рисунка образец (шаблон или пластина) механически перемещается между соседними положениями экспонирования, что позволяет применять линзы меньшего диаметра для получения изображения на всей пластине.
В сканирующих системах (электронно- и ионно-лучевых) информация о топологии рисунка хранится в памяти ЭВМ и непосредственно используется для управления лучом. При этом экспонирование всей поверхности пластины осуществляется последовательно от точки к точке.
Мы остановимся на таких понятиях, как разрешающая способность, ширина линии, резкость краев, точность, дисторсия и прецизионность при получении изображения. В литографии не нашло применения физическое определение разрешающей способности как наименьшего углового расстояния, на котором две точки могут восприниматься раздельно. Более подходящим является инженерное определение, согласно которому разрешающая способность равна числу высококонтрастных пар линий на единицу длины. В этом случае понятие разрешения тесно связано с параметром ширина линии, т.к. определяет наименьшую ширину линии или наименьшее расстояние между двумя воспроизводимыми линиями. Точность характеризует пространственные размеры изображения в стандартных единицах. Дисторсия является мерой, сохранения относительных размеров рисунка, прецизионность определяет, насколько совпадают рисунки, изготовленные в одном технологическом цикле.
2. Оптическая литография
2.1.Контактная печать
Контактная печать является самым первым методом нормирования рисунка на полупроводниковых пластинах. При использовании этого метода шаблон, содержащий нужный рисунок, накладывается на покрытую фоторезистом пластину и экспонируется светом, в результате чего на резисте те образуется засвеченные и не засвеченные области. С помощью последующего проявления (селективного травления) происходит удаление участков фоторезиста в соответствии с временем экспонирования. Разрешающая способность этого метода около 2 мкм и ограничивается дифракционными эффектами между двумя соседними линиями (рис. 14.1).

Рисунок 14.1 Контактная печать:
а - профиль распределения интенсивности; б - поперечное сечение шаблонов и резистивной пленки
При использовании для освещения когерентного излучения улучшается контрастность изображения, увеличивается его четкость (вследствие когерентности эффектов дифракции) и остановится более резким спад интенсивности в краевых областях. Выдерживая одно и то же время экспонирования и обеспечивая однородность светочувствительного материала, можно сохранять ширину линии с приемлемыми допусками.
Основной недостаток контактной печати состоит в изнашивании фотошаблона при его многократном использовании. Плотное соприкосновение фотошаблона с подложкой приводит к возникновению дефектов на соприкасающихся поверхностях, как шаблона, так и резиста. Накопление дефектов и частиц фоторезиста, прилипающих к фотошаблону, при многократном экспонировании приводит к его быстрому износу. Допустимое число экспозиций зависит от сложности шаблона, определяемой степенью интеграции, и прочности поверхности шаблона.
Эмульсионные фотошаблоны для экспонирования больших ИС обычно используются не более десяти раз. Лучше применять шаблоны, покрытые хромом, окислом железа или другими металлами, т.к. они допускают периодическую очистку и могут использоваться для гораздо большего числа экспозиций. На практике шаблоны с твердым покрытием могут использоваться более 100 раз.
Разрешающая способность метода контактной печати может быть повышена, если для экспонирования резиста использовать более коротковолновое излучение, т.к. при этом уменьшается влияние дифракции. Глубокий ультрафиолет (с длиной волны 200-260 нм) позволяет получать ширину линий 0,5 мкм, т.е. примерно, вдвое большую длины волны излучения.
По мере того как размер кристалла (чипа) возрастает, а детали изображения становятся мельче, возникает необходимость в более совершенных методах экспонирования, чтобы уменьшить число дефектов при более высокой степени интеграции. К ним можно отнести бесконтактную (с сохранением зазора между фотошаблоном и пластиной) и проекционную печать.
2.2. Бесконтактная печать
Пространственное разделение фотошаблона и подложки существенно уменьшает количество дефектов, возникающих из-за контакта. Однако дифракция проходящего света уменьшает разрешающую способность и одновременно ухудшает четкость изображения. Степень этих негативных явлений зависит от величины зазора между фотошаблоном и пластиной, который может быть неодинаковым вдоль пластины.
При малых зазорах основным источником искажений являются неровности поверхности пластины (особенно в пластинах большого диаметра), при больших - эффекты дифракции, поэтому возможности этого метода экспонирования характеризуются разрешением порядка 7 мкм (рис. 14.2).
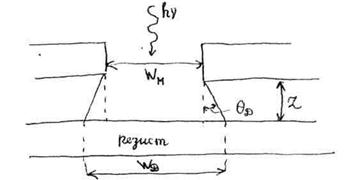
Рисунок 14.2 Геометрия бесконтактного способа печати. QD=50°/WM/l)
2.3. Проекционная печать
Метод проекционной печати заключается в проектировании изображения фотошаблона на пластину, покрытию фоторезистом, с помощью системы линз с высокой разрешающей способностью. В этом случае шаблон может использоваться неограниченное число раз, исключая случаи егоповреждения при эксплуатации, поэтому вполне оправдано применение очень высококачественных шаблонов. Глубина резкости оптической системы должна превышать - 10 мкм, т.е. диапазон, в котором обычно лежат отклонения пластин от идеальной плоскости, обусловленные высокотемпературной обработкой. Это ограничивает апертуру линз и, следовательно, разрешающую способность метода. Кроме того, затруднительно изготовить систему линз, одновременно удовлетворяющую условиям получения высококачественного (ограниченного явлением дифракции) изображения и равномерного освещения всей поверхности пластин, типовой размер которых в настоящее время составляет 10 см. Рассеяние света на оптическим элементах из стекла приводит к необходимости применения позитивных резистов. Обычные проекционные системы позволяют получать изображения с разрешением не менее 5 мкм. При увеличении диаметра пластин использование стационарных проекционных систем становится нецелесообразным.
В сканирующих (или пошаговых) проекционных системах изображение фотошаблона проектируется на определенную часть пластины. В этом случае за один раз Экспонируются гораздо меньшие площадки (порядка 1 см ), и затем экспонирование повторяется после перемещения изображения на соседнюю область пластины.
На рис. 14.3 указаны основные элементы проекционной системы: источник света, система линз, держатель фотошаблона, держатель пластин система совмещения.

Рисунок 14.3 Основные компоненты проекционной системы.
Обычно в фотолитографии используется ультрафиолетовый свет с длиной волны 330-400 нм. Более коротковолновое излучение не применяется, т.к. все известные комбинации фоторезистов, мощные источники света и оптические системы теряют свою эффективность на длинах волн короче 330 нм. Широкое распространение в проекционных системах получили дуговые ртутные лампы со спектром 330-400 нм, дуговые ксеноновортутные лампы и спектральные дейтеривые лампы для проведения литографии в глубокой ультрафиолетовой области.
 Характеристики оптических систем, используемых в проекционной печати, ограничиваются главным образом явлениями дифракции. Это означает, что проектирование и изготовление оптических элементов должны проводиться таким образом, чтобы их параметры, характеризующие передачу изображения, определялись в основном дифракционными эффектами, связанными с ограниченными апертурами конденсатора и проекционной оптики, а не эффектами аберрации. Основные параметры линз, используемых в проекционных системах, указаны на рис. 14.4.
Характеристики оптических систем, используемых в проекционной печати, ограничиваются главным образом явлениями дифракции. Это означает, что проектирование и изготовление оптических элементов должны проводиться таким образом, чтобы их параметры, характеризующие передачу изображения, определялись в основном дифракционными эффектами, связанными с ограниченными апертурами конденсатора и проекционной оптики, а не эффектами аберрации. Основные параметры линз, используемых в проекционных системах, указаны на рис. 14.4.
| Параметр | Значение |
| Фокусное расстояние | f |
| Диаметр апертуры | D |
| Число Р | F=f/D |
| Числовая апертура | NA=nsina=D/2f |
| Разрешающая способность | 1,22aF=Dx |
| Глубина резкости | ±lF2=±Da |
Рисунок 14.4 Основные параметры проекционных линз
Приведем определения основных параметров, характеризующих многоэлементные системы изображения. Числовая апертура (NA) определяется соотношением NA=nsina, где n - коэффициент преломления в пространстве изображения (обычно равный единице), 2a - - максимальный угол при вершине конуса лучей, попадающих в точку изображения на оптической оси проекционной системы (рис. 5). Эффективное число (F) проекционной системы равно F=1/2NA. Можно показать, что F=(1+М)f , где f - значение параметра F для системы с бесконечно удаленным объектом, М - действующее увеличение.
Изображение очень маленькой световой точки, сформированной линзой, имеющей дифракционные искажения, состоит из чередующихся световых колец, окружающих центральное яркое пятно, носящее название диска Эри. Расстояние ω, на котором интенсивность светового диска уменьшается вдвое, определяется выражением ω=0,5l/NA=1,0lF. Этот параметр в первом приближении соответствует наименьшему размеру, который может быть получен на резистивной пленке с помощью системы, имеющей дифракционные искажения.
Продольная аберация (или ошибка)
Da=±nl/2(NA)2=±2nlF2 (14.1)
приводит к возникновению оптической разности пути (ОРП) величиной ±l/4 в плоскости изображения. Значение ОРП ±l/4 не очень сильно влияет на качество изображения, т.к. при этом теряется лишь 20%светового потока в области диска Эри без каких-либо существенных изменений его диаметра. Параметр Dа известен как глубина резкости. Для F/3-оптической системы ω=1,2 мкм и Dа =±7,3 мкм. Несмотря на полезность параметра Dа, в фотолитографии глубину резкости удобнее определять как диапазон, в котором возможно изменение положения плоскости изображения для получения нужного размера рисунка.
Качество оптического изображения проекционной печати может также характеризоваться функцией модуляции передачи (ФМП), которая представляет собой зависимость степени модуляции интенсивности света в плоскости рисунка от пространственной частоты решетки, используемой в качестве источника изображения (решетка состоит из чередующихся прямоугольных линий, ширина которых равна расстоянию между линиями). На практике кривая ФМП соответствует синусоидальному распределению интенсивности света в плоскости предмета (рис. 14.5). Распределение характеризуется частотой (измеряемой числом пар линий на миллиметр) и модуляцией М0=Jmax-Jmin/Jmax+Jmin
где Jmax, Jmin - локальные максимумы и минимумы интенсивности.

Рисунок 14.5 Функция модуляции передачи (ФМП) и модуляция интенсивности (Mi) в плоскости рисунка при изображении решетки с пространственной частотой 333 пара линий/мм (ширина линий 1,5 мкм, расстояние между линиями 1,5 мкм). а - функция ФМП; б - изменение интенсивности в плоскости рисунка (Mi).
Отношение Jmax/Jmin называется контрастностью С. Величина модуляции Mi(v) в плоскости изображения может быть измерена с помощью фотодетектора очень малых размеров, перемещающегося поперек изображения решетки. Значение ФМП для данной частоты V определяется соотношением ФМП (V)= Mi(v)/M0. Для оптических систем с дифракционными ограничениями величина ФМП может быть также вычислена по формуле:
 (14.2)
(14.2)
где V- пространственная частота решетки; V0 - оптическая частота отсечки системы, зависящая от числовой апертуры NA и длины волны l в соответствии и с соотношением V0=2NA/l.
Оптические системы формирования изображения проекционных установок в зависимости от типа используемого источника излучения разделяются на когерентные и некогерентные. Если фотошаблон (или решетка) освещаются слабо расходящимся световым потоком от точечного источника, то изображение в проекционной установке является когерентным или почти когерентным, т.к. в плоскости изображения (пластины) свет, дифрагированный решеткой, когерентен по амплитуде. Информации о пространственной частоте решетки можно получить, используя только дифрагированный световой поток. Направление первого дифракционного пика определяется из формулы:
n(a+в)sinq=Nl (14.3)
а пространственная частота равна
V=(a+в)-1=nsinq/l (14.4)
для N=1. Для получения изображения необходимо, чтобы q=a, где a зависит от числовой апертуры проекционной оптики (NA=nsinl).Поэтому максимальная частота решетки, которая может быть передана когерентной проекционной системой, равна

где Vc-частота отсечки. В случае проекционной системы, в которой решетка освещается лучами от всех участков протяженного некогерентного источника света, каждый отдельный луч подвергается дифракции решеткой и формирует своё изображение в плоскости пластины. Т.к. определенных фазовых соотношений между различными лучами света от протяженного источника не существует, их изображения в плоскости пластины складываются некогерентно.
Для лучей, падающих на решетку под углом I, направление первого дифракционного максимума удовлетворяет соотношению
n(a+в)(sinI+sinq)=l (14.6)
Для получения изобоажения необходимо, чтобы I, q£a. Поэтому
 (14.7)
(14.7)
Следовательно, Vmax(некогерентн.)=2Vmax(когерентн.).
Величина ФМП для некогерентного источника монотонно уменьшается, начиная со значения при V=q до нуля при частоте отсечки Vc=1/lF. ФМП для когерентного источника остается равной единице вплоть до частоты отсечки Vc=1/2lF, где она резко падает до нуля. С математической точки зрения величина ФМП в некогерентной системе является весовой функцией, которая позволяет оценивать интенсивность отдельных составляющих в спектре изображения. Если известны спектр изображаемого объекта и кривая ФМП, то некогерентное изображение может быть восстановлено. Когерентные системы труднее поддаются интерпретации, поскольку они чувствительны как к фазе отдельных составляющих спектра изображения, так и к их амплитудам. Т.к. величина ФМП не содержит информации о фазе, в этом случае изображение не может быть восстановлено, исходя из ФМП.
Обычно считаемся, что минимальная величина ФМП должна быть равна 60% для проработки минимальных деталей при использовании позитивного резиста.
Если некогерентная величина ФМП (V) определяется на основе измерении или вычислений, то распределение интенсивности в плоскости изображения может быть получено, исходя из распределения интенсивности в плоскости объекта (шаблона). Для этого необходимо использовать следующею последовательность преобразований.
Пространственно-частотное распределение объекта изображения I0(V) получается из соответствующего распределения интенсивности I0(х) с помощью преобразования Фурье FТ:
J0(V)=FTJ0(x) (14.8)
На практике используется дискретное преобразование Фурье, подразумевающее периодичность разлагаемой функции. Пространственно-частотное распределение для изображении определяется формулой
Ji(V)=Fmp(V)J0(x) (14.9)
а изменение интенсивности Ji(x) - инверсным фурьепреобразованием пространственно-частотного распределения.
 (14.10)
(14.10)
Произведение распределения интенсивности (Вт/см2) на время экспозиции (с) дает величину распределения плотности падающей энергии (Дж/см2) или дозы по поверхности пленки фоторезиста.
В большинстве систем проекционной печати источник света значительно меньше объектива. В этом случае формирование изображения следует считать квазикогерентным.
Для контактной печати или бесконтактной печати с небольшим зазором используется хорошо коллимированное когерентное излучение. В случае некогерентного излучения изображение на поверхности пластины будет размыто полутенями. На практике источники света деколлимируются на несколько градусов, чтобы устранить интенсивные дифракционные явления, возникающие при очень малых размерах коллиматора.
3. Физика фотолитографии
3.1. Позитивный фоторезист
В оптической литографии и микроэлектронике используются фоторезисты, покрывающие тонкой пленкой поверхность пластины, на которую должно быть нанесено изображение. Фоторезистивная пленка экспонируется в синем или ультрафиолетовом свете, после чего в соответствии с рисунком фотошаблона на ней образуются засвеченные и незасвеченные области. При проявлении происходит селективное удаление резиста в соответствии с полученной экспозицией. Оставшийся рисунок фотрезиста на поверхности пластины используется в качестве маски при проведении травления, металлизации, распыления, испарения или других технологических операций, применяемых в микроэлектронике.
Оптическая литография аналогична обычной фотографии в том смысле, что светочувствительная тонкая пленка изменяет свои химические свойства под действием света, а изображение появляется после соответствующего проявления. Однако как химические процессы, так и результирующие изображения различны. В фотографии с соединениями серебра взаимодействует большое количество фотонов, тогда как в оптической литографии для позитивного резиста разрушение органического соединения происходит в результате поглощения одного фотона. Фотографическое изображение соответствует распределению интенсивности света, литографическое изображение соответствует профилю фотошаблона. Проявление в фотографии - это процесс преобразования активированных светом кристаллов галоидного серебра в металлическое серебро; проявление позитивного фоторезиста - процесс травления. Как видно из табл. 1, эти различия достаточно существенны, поэтому для понимания оптической литографии должна быть построена соответствующая математическая модель.
При проявлении позитивных или негативных фоторезистов удаляются соответственно освещенные или неосвещенные области. Рассмотрим в первую очередь количественную модель литографического процесса при использовании позитивного фоторезиста. Существенные различия между поведением позитивного и негативного резистов приводят к тому, что математический аппарат, описывающий экспонирование и проявление одного из них, неприменим для другого.
Позитивный фоторезист обычно состоит из трех компонентов: смолы, обеспечивающей изготовление резиста в виде тонкой пленки, фото- активного соединения и легко испаряющегося растворителя, позволяющего наносить резист на пластину в жидком виде. В сухой пленке (толщиной 0,3-2 мкм) фотоактивное соединение (ингибитор) препятствует растворению резиста в водно-щелочном проявляющем растворе. Здесь специально упоминается об этой роли ингибитора как вещества, препятствующего растворению резиста. Его разрушение светом создает побочные соединения, которые не препятствуют растворению резиста и увеличивают скорость удаления резиста проявителем.
Таблица 14.1 Сравнение процессов фотографии с оптической литографией
| Процесс | Фотография | Оптическая литография |
| Экспонирование | Многофотонное поглощение | Поглощение одного фотона (разрыв связей для позитивных резистов; полимеризация для негативных резистов) |
| Формирование изображения | Интенсивность света | Профиль маски |
| Проявление | Образование кристаллов серебра из скрытого изображения | Травление |
Процессы экспонирования и проявления для лучшего понимания целесообразно рассматривать отдельно. Экспонирование светом определенной длины волны вызывает химическое видоизменение в фоторезисте, что приводит к потере его защитных свойств, т.е. разрушению ингибитора. Эффект химического видоизменения локализован в окрестности точки, где произошло поглощение фотона, и уровень экспозиции может изменяться в широких пределах в пленке резиста. Проявление заключается в процессе травления, при котором происходит селективное удаление резиста со скоростью, зависящей от количества разрушенного ингибитора. Связь между процессами экспонирования и проявления определяется количеством ингибитора, оставшегося неэкспонированным.
3.2. Свойства фоторезиста
Фоторезистивная пленка после нанесения на подложку и высушивания должна быть изотропной и однородной. Она должна иметь не только постоянную толщину (как в микро- так и в макро-масштабе) по всей используемой площади, но и быть химически изотропной, чтобы ее реакция на экспонирование и проявление была однородной по всей поверхности. Особое внимание должно быть уделено устранению радиального изменения толщины (в виде расходящихся лучей звезды), которое может возникать при нанесении резиста на центрифуге.
Т.к. величина оптического поглощения - важная характеристика резиста, следует удовлетворить некоторым требованиям. Оптическое рассеяние должно быть настолько малым, чтобы оптические свойства резиста могли полностью описываться показателем преломления и коэффициентом поглощения a.
Показатель преломления в комплексном виде записывается следующим образом:
 , где n - действительная часть показателя (n=1,68 для фоторезиста типа AZ1350J и длины волны 404,7 нм), k - коэффициент затухания:
, где n - действительная часть показателя (n=1,68 для фоторезиста типа AZ1350J и длины волны 404,7 нм), k - коэффициент затухания:
k=al/4p, k=0,002 для резиста типа AZ1350J при 404,7 нм. Поэтому падающий на резист свет ослабляется на каждый микрометр пути на величину, характеризуемую множителем

 (14.11)
(14.11)
После экспонирования концентрация ингибитора существенно уменьшается, причем эффективный фактор ослабления защитных свойств обычно составляет около 0,10 мкм. Поэтому для большей части времени экспонирования резист можно считать прозрачным.
Т.к. ингибитор вносит главный вклад в процесс поглощения света, обычно считают, что кривые спектра поглощения и спектральной чувствительности для позитивного резиста эквивалентны.
3.3. Экспонирование.
Концентрация ингибитора обычно составляет около 30% сухой фоторезистивной пленки. Сильное поглощение, связанное с фоточувствительностью резиста, приводит к значительному оптическому поглощению на длине волны экспонирования. По мере разрушения ингибитора поглощение уменьшается. Для описания этого процесса можно использовать понятие относительной стойкости М(Z, t), характеризующее концентрацию ингибитора для любой координаты z. и времени экспонирования t по отношению к его концентрации перед экспонированием. Большинство фоторезистивных пленок имеет слабое рассеяние, поэтому постоянная поглощения a- определяется соотношением
a=AM(z,t)+B (14.12)
где А и В - экспериментально определяемые параметры материала, характеризующие соответственно зависящую и не зависящую от экспозиции части постоянной поглощения.
Скорость разрушения ингибитора зависит от интенсивности света в данной точке I(z, t), концентрации ингибитора и экспериментально определяемой чувствительности С:
 (14.13)
(14.13)
где А,В и С - коэффициенты, зависящие от типа фоторезиста и длины волны света.
Изменение интенсивности света в бесконечно толстом слое резиста или пленки, покрывающей подложку определяется соотношением
 (14.14)
(14.14)
При отсутствии внутренних отражений распределение ингибитора не зависит от толщины резиста, что делает вычисления справедливыми для пленок толщиной до 2 мкм. Отметим, что даже для этих относительно простых условий концентрация ингибитора не остается постоянной, а непрерывно изменяется с момента начала экспонирования.
Обычно уравнения (14.13) и (14.14) решаются методами численного интегрирования относительно М(z,t) и I(z,t) при заданных параметрах А, В, С и I0. Методы экспериментального определения коэффициентов А, В и С, используемые в такой модели формирования изображения, описаны в научно-технической литературе.
3.4. Интерференция
Интерференция света, возникающая из-за неравенства показателей преломления резиста и подложки, может вызывать локальные изменения интенсивности в фоторезистивном материале. Уменьшение средней величины интенсивности по глубине связано с поглощением света, а модуляция интенсивности возникает из-за интерференции стоячих волн, отраженных от границы раздела резист-подложка. Концентрация ингибитора также оказывается модулированной по глубине благодаря изменению интенсивности в резистивной пленке. Анализа указанных интерференционных эффектов целесообразно проводить при некоторых упрощающих предположениях, позволяющих выявить основные закономерности.

Рисунок 14.6 Возникновение стоячей волны при полном отражении от подложки:
а - многократное отражение на границе раздела резист-подложка;
б - распределение интенсивности света в фоторезистивной пленке.
Будем считать, что монохроматический световой поток нормально падает на слабо поглощающую пленку толщиной d , прилегающую к полностью отражающей поверхности (подложке, rs=1), расположенной в плоскости z=d (рис. 14.6 a). Если падающая световая волна 1 имеет единичную амплитуду, то волна 2 в пленке (в предположении, что эффекты поглощения пренебрежимо малы) может быть представлена в виде
E2(z)=E2sin(ωt-kz+j) (14.15)
где E2=(1-r2)1/2. В формуле (15) г=(n-l)/(n+1)
коэффициент отражения границы раздела воздух-пленка, k=2ph/l и nдействительная часть диэлектрической постоянной пленки,  .
.
Амплитуда отраженной волны 3 равна
E3(z)=E2sin[ωt-k(2d-z)+j+p] (14.16)
Изменение фазы на p происходит во время отражения. Суммирование Е2 и E3 дает стоячую волну
 (14.17)
(14.17)
Очевидно, что расположение максимумов (пучностей) и минимумов (узлов) не зависит от фазы ωt+j падающей волны, которая может быть произвольной. Огибающая функция (J~E2) для интенсивности стоячей волны имеет вид
J23=4J2sin2[k(d-z)] (14.18)
Расположение экстремумов (при измерении от подложки) определяется следующими условиями (N1=0, 1, 2, …):
n(d-z)=l/4, 3l/4, …, (2N1+1)l/4 (14.19)
для максимумов (пучностей) и
n(d-z)=l/2, l, …, N1l/2 (14.20)
для минимумов (узлов). Учет дополнительных отражений волн (4, 5, …) не оказывает влияние на положение максимумов и минимумов. Но приводит к изменению амплитуды стоячей волны.
В случае «неидеальных» подложек (Si, Al, Pt, Au …) границу раздела пленка-подложка нельзя считать полностью отражающей (rS=1). Кроме того, при отражении фаза изменяется меньше чем на p. Это вызывает сдвиг положения узлов и появление конечной интенсивности света в точках минимума. Можно показать, что расположение узлов интенсивности относительно подложки и отношение интенсивности в максимуме к интенсивности в минимуме не зависят от поглощения света в резистивной пленке. Однако модуляция стоячей волны в принципе зависит от поглощения в резисте.
Для расчета распределения абсолютной величины интенсивности в резистивном материале необходимо учитывать параметры источника света (лампы) и отражательные характеристики оптических элементов. В оптической фотолитографии в качестве источника света обычно используется ртутная дуговая лампа высокого давления, излучающая в диапазоне длин волн 200-600 нм. Для установок, в которых используется отражающая оптика, спектр излучения, падающего на пластину, по существу, аналогичен спектру источника света. Если S(l) – передаточная характеристика установки, то спектр излучения, достигающего фоторезистивной пластины, равен S(l) F(l) R(l) d(l), где R(l) – спектральная чувствительная фоторезиста. Для каждой фиксированной частоты света стоячая волна в пленке резиста вызывает изменение интенсивности света по глубине пленки в соответствии с формулой (18). Поэтому результатирующее распределение интенсивности света в фоторезисте (для нескольких длин волн li) пропорционально
 (14.21)
(14.21)
Т.к. коэффициенты преломления обычно используемых резистов (hr~1,6) очень близки к коэффициентам преломления SiO2 и Al2O3 эта упрощенная модель также справедлива для систем фоторезист-SiO2/Si.
Важным параметром, используемым для описания взаимодействия излучения J(z) с резистивной пленкой, является функция, характеризующая изменением дозы по глубине. Эта функция связывает скорость поглощения энергии (потери энергии dE/dZ в электронно-лучевом и ионно-лучевом резистах) с глубиной проникновения излучения z в резистивную пленку.
Зависимость дозы от координаты D(z)определяется произведением интенсивности света или электронного потока на время экспозиции t
D(z)=J(z)t (14.22)
Интенсивность фотонов на расстоянии z равна J(z)=J0F(z),
где J0 - интенсивность света на поверхности фоторезиста, F(z) - функция изменения дозы по глубине. Отсюда
D(z)=J0F(z)t=D0F(z) (14.23)
где D0 - величина дозы при z=0. Функция F(z) изменяется с координатой z вследствие интерференции света в резистивной пленке.
Поглощение энергии в единице объема связано с химическими процессами (полимеризацией, разрывом валентных связей) в фоторезисте. Если изменение интенсивности света (фотон.см-2.c-1) вследствие поглощения в слое резиста толщиной dz на глубине zравно dJ, то скорость поглощения энергии равна
 (14.24)
(14.24)
где hV- энергия фотонов, a - линейный коэффициент поглощения. Энергию, поглощенную за время t можно получить путем интегрирования. Для протекания химических реакций на глубине z количество поглощенной энергии в единице объема должно равняться
Еа(z)=ahVD0F(z) (14.25)
откуда может быть найдена доза падающего излучения D0. Отметим, что если функция, характеризующая изменение дозы по глубине, для фотолитографии определяется интерференцией в пленке резиста, то в электронно-лучевой литографии аналогичная функция l(z) связана с рассеянием и потерями энергии. Линейный коэффициент поглощения (соответствующий коэффициенту a для света) в этом случае равен  , где RG - пробег Грюна. Энергия фотона hV в электронно-лучевой литографии заменяется на кинетическую энергию электрона Е(z), зависящую о глубины проникновения z.
, где RG - пробег Грюна. Энергия фотона hV в электронно-лучевой литографии заменяется на кинетическую энергию электрона Е(z), зависящую о глубины проникновения z.
3.5. Проявление резиста
Проявление позитивного резиста представляет собой поверхностную реакцию травления с ограниченной скоростью. Скорость проявления определяется химическим составом резиста и травителя, а также зависит от концентрации ингибитора на экспонированной поверхности резиста. Экспериментальная кривая, связывающая скорость проявления R с концентрацией ингибитора М, позволяет найти соотношение между временем экспонирования и временем проявления. Согласно экспериментальным данным, зависимость R(M) может быть записана в следующем виде:
R(M)=exp(E1+E2M+E3M2) (14.26)
Значения коэффициентов E1, E2, E3 приведены на рис. 14.7, где также показан профиль травления.

| Параметр | Значение |
| Подложка | Si |
| SiO2 | 60 нм |
| Фоторезист | АZ1350J |
| Партия 30 000 | |
| Толщина | 583,6 нм |
| Коэффициенты экспонирования | А=0,54/мкм |
| В=0,03/мкм | |
| С=0,014 см2/мДж | |
| n=1,68 | |
| Длина волны света | 435,8 нм |
| Энергия экспонирования | 57 мДж/см2 |
| Проявление | Аz-растворитель с водой (1:1)при 22°С |
| Коэффициенты, определяющие скорость травления | Е1=5,27 |
| Е2=8,19 | |
| Е3=-12,5 |
Рисунок 14.7 Профиль линии позитивного резиста типа АZ1350J толщиной 1 мкм после обработки в Аz -растворителе с водой (1:1) в течение 85с
а - профиль края резиста;
б - условия экспонирования
3.6. Негативный фоторезист
Негативный фоторезист можно рассматривать как фоточувствительный материал с эффективной пороговой энергией ЕТ. Если энергия фотонов Е, падающих на резист, меньше порогового значения ЕТ, то резист удаляется в процессе проявления. Если же Е>ЕТ, то резист становится нерастворимым в проявителе и получающееся изображение действует как защитная маска. Величина пороговой энергии зависит от множества факторов, характеризующих резист. Например, значение ЕТ возрастает при увеличении толщины резиста и уменьшается, если подложка имеет «аномальное» отражение. Очевидно, что величина пороговой энергии, зависит от типа фоторезиста. Приблизительная оценка значения ЕТ может быть получена из характеристической кривой резиста (зависимости глубины проявления от энергии экспонирования).
Размер изображения на фоторезистивной пленкой определяется соотношением между эффективной пороговой энергией экспонирования и распределением энергии из-за дифракции света на краях фотошаблона (рис. 14.8).
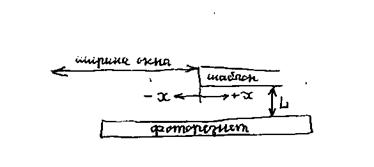
Рисунок 14.8 Дифракция света на краю фотошаблона.
Вблизи края маски распределение интенсивности света, падающего на поверхность фоторезиста, можно аппроксимировать выражением
J=kJ0exp(-mV) (14.27)
Распределение энергии по координате определяется формулой
E=kEiexp(-mV) (14.28)
где Е – энергия света, падающего на резист, Ei - энергия света, падающего на резист, V- приведенная координата V=x(2/lL)1/2, при V=0, m - наклон кривой I/I0 на краю шаблона (V=0). Коэффициенты k и m зависят от оптических характеристик используемого для экспозиции оборудования и конфигурации воспроизводимого рисунка. Из-за дифракции эффективный размер изображения на фоторезисте не равен размеру окна в фотошаблоне. Граница изображения в фоторезисте соответствует приведенной координате V , при которой энергия света, падающего на резист, становится равной пороговой энергии экспонирования Е=ЕТ. Величина V равна
V=(1/m)ln(E1/ET)+ln(k) (14.29)
На рис. 14.8
V=x(2/lL)1/2 (14.30)
где х - расстояние от края фотошаблона, l - длина волны падающего света, L - зазор между фотошаблоном и пластиной. Эффективная граница изображения расположена на расстоянии х от края шаблона, и разница между размером получаемого изображения d равна
d=2x=(2/m)(l/2)1/2L1/2[lnEi-(lnET-lnk)] (14.31)
При d>0 изображение на фоторезисте больше размеров щели в фотошаблоне, а при d<0 - меньше. Заметим, что d=0, когда Еi=ЕT/k=E0.
4. Проекционные системы
Наиболее широкое распространение получила оптическая проекционная система с использованием зеркальной оптики (рис.14а). Система работает при единичном увеличении изображения. Одновременно освещаются только серпообразная часть фотошаблона и соответствующий участок образца, и лишь эта часть рисунка переносится на образец. Для получения полного изображения производится параллельный сдвиг фотошаблона и пластины в одном и том же направлении с помощью единой системы перемещения. Полное экспонирование пластины осуществляется за один цикл сканирования. Оптическое увеличение зеркальной системы равно единице, т.е. размеры фотошаблона и получаемого на пластине рисунка равны. Разрешение системы соответствует воспроизведению линии шириной 3 мкм, что сравнимо с разрешающей способностью обычной системы бесконтактной печати с ультрафиолетовым освещением. Точность совмещения составляет ±1 мкм. Для линий шириной 2 мкм глубина резкости ±5 мкм, для линий шириной 3 мкм она равна ±12,5 мкм.
Экспонирование производится излучением от ртутной дуговой лампы, имеющей широкий спектр, поэтому время экспонирования лежит в пределах 1 мин с минимальным значением 6 с. При оценке производительности системы необходимо учитывать, также время совмещения, которое выполняется вручную.
Проекционные системы с пошаговым перемещением и уменьшением изображения аналогичны системам изготовления эталонных фотошаблонов для контактной печати и переноса изображения непосредственно на пластину. Размер рисунка между шаблоном и пластиной уменьшается в 4 или 10 раз. Для получения изображения на всей пластине образец механически перемещается от одного положения к другому. В данной системе глубина резкости при получении изображения линий шириной 1 мкм очень мала (около - 1 мкм), поэтому для каждого кристалла должна быть выполнена дополнительная подфокусировка. Кроме того, требуется строгая юстировка положения кристалла в горизонтально плоскости. Большинство работающих в настоящее время систем используют два вида совмещения. Прежде всего, устанавливается взаимное расположение фотошаблона и пластины, а затем во время пошагового сканирования с помощью лазерной интерференционной системы тщательно контролируется движение стола, на котором расположен образец. Производительность такой системы достаточно высокая, т.к. для пластины требуется лишь одно совмещение.
Новые системы с пошаговым экспонированием позволяют экспонировать 50 пластин диаметром 10 см в 1 ч (время экспонирования 0,3 с, продолжительность перемещения стола 0,3 с) с минимальной шириной линии менее 2 мкм и точностью совмещения, лучшей ±0,5 мкм. В этих системах установка взаимного расположения шаблона и пластины осуществляется для каждого положения кристалла с помощью специальных автоматических систем, которые могут также компенсировать искажения, появляющиеся вследствие изменения температуры или проскальзывания пластины. Точность новых систем может достигать 0,25 мкм, а их разрешающая способность в принципе позволяет изготовлять линию шириной, около 1 мкм.
5. Ионно-лучевая литография
5.1. Введение
Ионные пучки в субмикронной литографии приобретают все большее значение. Они могут использоваться не только для непосредственной прорисовки рисунка на пластине, но и для изготовления шаблонов. При этом ионно-лучевые системы могут заменить соответствующие электроннолучевые устройства. Кроме того, они могут использоваться для ионной имплантации, прямого ионного распыления (травления) или для создания радиационных повреждений, ускоряющих последующие процессы распыления или травления. Формирование рисунка на оксидных слоях происходит вообще без какого-либо резиста, т.к. увеличение скорости травления связано с радиационными повреждениями. Дозовая зависимость скорости травления имеет насыщение, которое для SiO2 начинается с полного потока порядка 2х1016 протон/см2. Характер травления окисла SiO2 показан на рис. 14.9. Увеличение скорости окисления имплантированного кремния может использоваться для образования окисных слоев разной толщины (рис. 14.10). После имплантации ионов кремния и термического окисления толщина окисла оказывается больше в облученных областях. Имплантация окисла оказывается больше в облученных областях. Имплантация ионов азота в кремний уменьшает скорость окисления облученных областей; кроме того, внедренные в тонкие пленки ионы азота изменяют проводимость пленок.
Облучение ионами позволяет непосредственно формировать рисунки на тонких металлических (слоях Ni или Мо), которые затем могут использоваться в качестве металлических ионочувствительных резистов. Процесс нанесения рисунка с помощью такого металлического резиста показан на рис. 14.11.
Разрешающая способность ионно-лучевой литографии по своей природе очень высока, т.к. вторичные электроны, выбиваемые ионным пучком, имеют малую энергию, т.е. небольшой пробег, и поэтому практически исключается обратное рассеяние.
Ионно-лучевые проекционные системы (с уменьшением или без уменьшения размеров передаваемого изображения) могут использоваться в безрезистивной технологии для формирования рисунков на полупроводниках (Si, Ga, As, поликремний), изолирующих слоях (SiO2, Si3N4), металлах (Al, Ni, Mo, Au), а также для нанесения изображения на тонкие органические пленки (резисты). Другой возможный способ заключается в теневом нанесении рисунка через тонкопленочную маску, рисунок которой должен состоять из участков, поддерживаемых самой структурой. Использование таких масок ограничено случаями, когда в рисунке нет теневых участков, со всех сторон окруженных окном и как бы свободно висящих. Применение тонкой аморфной мембраны в качестве полностью прозрачного по отношению к легким ионам держателя позволяет решить эту проблему, однако, ценой значительного углового рассеяния ионов в мембране. Возникающая угловая дисперсия затрудняет точное копирование рисунка. Контактная печать также не лишена недостатков, т.к. приводит к уменьшению процента выхода и снижению надежности.
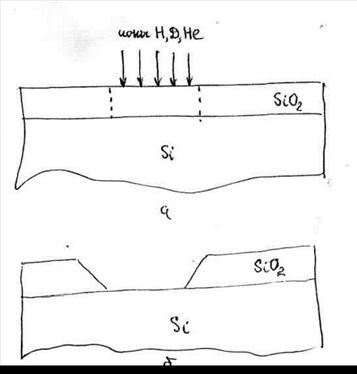
Рисунок 14.9 Формирование рисунка с помощью радиационного повреждения окисла SiO2 ионами Н, D, Не: а - экпонирование; б - после травления
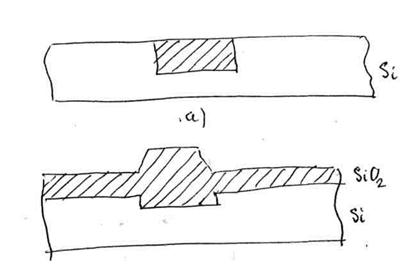
Рисунок 14.10 Формирование рисунка на кремнии путем создания разной толщины пленки SiO2:
а - имплантация ионов кремния; б - увеличение скорости окисления облученной ионами области при термическом окислении (950°С)

Рисунок 14.11 Формирование рисунка на металлических резистивных слоях:
а - напыление слоя никеля на SiO2-Si и имплантация; б - травление имплантированной области; в - травление; г - удаление слоя никеля
Другой возможный способ маскирования заключается в использовании кремниевой мембраны с ориентацией <110> толщиной 3-6 мкм, на которую нанесен металлический рисунок (тонкая пленка золота толщиной 100 нм). Резистивная пленка экспонируется через эту монокристаллическую кремниевую фольгу в направлении каналирования коллимированным пучком с энергией 300-2000 кэВ. Способ маскирования основывается на эффекте деканалирования в тонком металлическом слое, а также на разнице потерь энергии для направления каналирования и случайных направлений (рис. 14.12).

Рисунок 14.12 Монно-лучевая печать, основанная на эффекте каналирования.
Тонкие сфокусированные пучки ионов могут использоваться для экспонирования резистов, обработки материалов в машиностроении и изменения электрических и механических свойств полупроводников при имплантации. Все эти операции могут выполняться непосредственно без применения маскирующих шаблонов.
Практическое применение всех рассмотренных литографических методов до настоящего времени сдерживалось из-за слабой интенсивности ионных источников, но разработка высокоинтенсивных и стабильных жидкометаллических источников ионов открывает широкие перспективы в этом направлении.
5.2. Резисты для ионно-лучевой литографии
Ионное облучение вызывает значительные химические превращения в резистивных материалах. Суммарные потери энергии на единицу длины свободного пробега для ионов гораздо больше, чем для электронов, поэтому можно ожидать, что чувствительность к ионному облучению, выраженная через количество падающего заряда на единицу площади, будет очень большая. Разрешающая способность также должна быть достаточно высока, т.к. боковое рассеяние ионного пучка в резистивных пленках гораздо меньше, чем в случае электронов. Рассеяние энергии ионов происходит в результате столкновения их с электронами и ядрами атомов резиста. Радиационные повреждения, вызываемые этими двумя механизмами рассеяния, можно считать независимыми, т.к. они имеют разную физическую природу. Вклад этих механизмов, в химические превращения различен и соответствует характеру изменения потерь энергии с глубиной проникновения ионов. Общее число разорванных связей находится суммированием числа связей, нарушенных при столкновении ионов с электронами и ядрами, поэтому средний молекулярный вес Мf после экспонирования равен:
 (14.32)
(14.32)
где Ge(z) и Gn(z) - приводящие к разрыву связей радиационные повреждения, вызываемые соответственно столкновениями ионов с электронами и ядрами.
Скорость растворения полимера может быть выражена следующим образом:
 (14.33)
(14.33)
где R0, b и a - экспериментально определяемые коэффициенты. Для очень тонкой резистивной пленки величины Se(z) и Sn(z) можно считать постоянными и толщина резиста d, удаляемая при проявлении, равна d=RT, где Т - время проявления. Для толстой пленки резиста толщина растворенной пленки d и время проявления Т связаны следующим соотношением:
 (14.34)
(14.34)
Для резиста ПММА лучшее совпадение теоретических результатов, полученных на основании формулы (34), и экспериментальных данных имеет место при R0=8,4 нм/мин, b=0,39х108 нм/мин; a=1,41, Ge=1,7, Gn=0,9.
Число радиационных повреждений, образующихся при столкновении ионов с электронами, примерно равно числу повреждений в случае электронного облучения, где G=1,9. Столкновение с ядрами приводит к возникновению вдвое меньшего числа радиационных повреждений по сравнению с экспонированием резиста ПММА электронным лучом.
5.3. Жидкометаллические ионные источники
Жидкометаллические ионные источники были разработаны для широкого круга металлов (Ga, Bi, Ge, Hg, Au, сплав Вуда и щелочные металлы).
Принцип действия ионного источника основан на формировании стабилизированного полем конуса жидкого металла (конуса Тэйлора), из которого под действием поля происходит испарение ионизированных атомов. К вершине конуса металл поступает из вязкого потока на поверхности эмиттера за счет капиллярных сил и градиента электростатического поля вблизи наконечника эмиттера.
В сканирующем ионно-лучевом устройстве жидкометаллический галлиевый источник используется для формирования сфокусированного луча, представляющего собой пучок ионов Gа+ с током 0,1 нА и диаметром 0,1 мкм. Экспериментально определенная яркость источника в плоскости изображения равна 
при энергии ионов Gа+ 57 кВ. Здесь площадь эмиттирующей области  , где а0=0,2 рад - половина угла при вершине конуса вылетающих ионов, rа=60 нм. Для галлиевых пучков величина тока эмиссии может достигать 1-10 мкА.
, где а0=0,2 рад - половина угла при вершине конуса вылетающих ионов, rа=60 нм. Для галлиевых пучков величина тока эмиссии может достигать 1-10 мкА.
Измерение распределения ионов по энергии показывает, что энергетический спектр (  ) расширяется при увеличении тока и массы частиц. Расширение спектра для Ga, Jn и Bi составляет соответственно 5,14 и 21 эВ при угловой интенсивности 20 мкА/ср.
) расширяется при увеличении тока и массы частиц. Расширение спектра для Ga, Jn и Bi составляет соответственно 5,14 и 21 эВ при угловой интенсивности 20 мкА/ср.
Даже при малых углах (примерно 1 мрад) можно получить ток ионного пучка в несколько наноамперов.
5.4. Сканирующие системы
На рис. 14.13 показан высокоинтенсивный сканирующий ионный зонд на основе жидкометаллического источника. Ионный луч формируется ускоряющей линзой с единичным увеличением и расположенной после нее дефлекторной линзой для сканирования. Использование электростатического дефлектора позволяет перемещать пучок в направлениях x и y. При управлении дефлектором с помощью ЭВМ можно перемещать пучок линейно или сканировать со скоростью 5х104 мкм/с.
Диаметр пятна ионов, ограничиваемый хроматической аберацией и аксептансом линзы a0, определяется соотношением
D=CCa0(DE/E0)»100нм
где a0=1,2 мрад, СС=33 мм, DE»14 эВ, E0»5,7х104 эВ. Этот тонкий миропучок может использоваться для микрообработки, легирования экспонирования резиста. Необходимо отметить, что экспонированный ионами резист не обладает теми свойствами, которые можно ожидать при экспонировании резиста электронами.
В заключение можно сказать, что жидкостные ионные источники имеют очень хорошие свойства с точки зрения применения в микроэлектронной технологии. Токи ионов от 1 до 100 мкА при угловой интенсивности источника до 10-4 А/ср примерно в 100 раз превышают соответствующие характеристики ионного источника с газовой средой.
Ультрафиолетовые, рентгеновские, электронно- и ионно-лучевые системы имеют разрешающую способность менее одного микрометра. Размер пятна ионного пучка в принципе может быть даже меньше, позволяя получить разрешение на уровне 10-50 нм. Материал настоящей главы показывает, что для проведения субмикронной литографии существует несколько возможностей. Выбор того или иного способа в технологическом цикле субмикронного производства зависит, в частности, от характеристик изготавливаемых приборов.

Рисунок 14.13 Схематическое изображение галлиевого сканирующего ионного зонда с ускоряющим напряжением
| <== предыдущая страница | | | следующая страница ==> |
| Блок металлизации | | | Приемы самосовмещения при формированиитранзисторных структур БИС |
Дата добавления: 2014-08-09; просмотров: 893; Нарушение авторских прав

Мы поможем в написании ваших работ!