
Главная страница Случайная лекция

Мы поможем в написании ваших работ!
Порталы:
БиологияВойнаГеографияИнформатикаИскусствоИсторияКультураЛингвистикаМатематикаМедицинаОхрана трудаПолитикаПравоПсихологияРелигияТехникаФизикаФилософияЭкономика

Мы поможем в написании ваших работ!
Введение ХМП
По мере увеличения количества слоев межкомпонентных соединений, планаризация диэлектрических и металлических слоев становится все более критичной. Методики планаризации при помощи оплавления слоев оксида кремния, сквозного травления при помощи жертвенного слоя фоторезиста или оксида кремния, нанесенного центрифугированием, становятся неадекватными для систем межкомпонентных соединений с более чем тремя уровнями металлической разводки. Эти методы обеспечивают ограниченную степень сглаживания или локальной планаризации и не способны обеспечить глобальную планаризацию. Глобальная планаризации как диэлектрических, так и металлических слоев возможна при помощи химико-механической планаризации. Это процесс впервые появился на фирме IBM в начале 80-х. В этом методе, высоко поднятый топологический рисунок селективно удаляется, при этом высота ступенек уменьшается на 90-95%.

Механическая полировка дополняется химическим воздействием, что обеспечивает селективное удаление материала. Пластина закрепляется на держателе планарной стороной вниз. Затем держатель прижимается к движущейся рабочей поверхности, содержащей полирующую подложку. На стол подаются капли водяной супензции, содержащей абразивные частицы, центробежная сила распределяет суспензию по полирующей подложке. В результате формируется коллоидный слой суспензии, который насыщает полировальник. Комбинация механических эффектов и химических реакций приводит к удалению материала с поверхности пластины.
|
|
|
|
|
|
| |
|
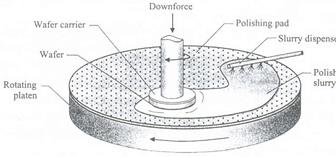
ХМП имеет три ключевых преимущества при производстве субмикронных ИС. Во-первых, для логических приборов (таких как микропроцессоры), ХМП делает возможными достижение высокого процента выхода годных и высокого быстродействия приборов с многоуровневой металлизацией, имеющих до 8 уровней металлизации. ХМП исключает проблему утонения металла над крутой топологией за счет планаризации топологического рельефа ИС. Во-вторых, приборы памяти (такие как ДОЗУ) получаются выгоду от применения ХМП, даже если они имеют межкомпонентные системы только с двумя уровнями металла. Для схем памяти плоская поверхность после проведения ХМП увеличивает глубину фокусировки при проведении фотолитографии. Это позволяет уменьшить размеры критических элементов ДОЗУ и, следовательно, размеры кристаллов без снижения процента выхода годных. Это позволяет снизить стоимость ДОЗУ. В-третьих, ХМП обладает парадоксальной способностью уменьшать плотность дефектов.
Механизм химико-механической полировки достаточно сложный и отличается для различных типов полируемых пленок. На скорость травления влияют многие факторы, включая тип пленки, давление (усилие прижатия к полировальнику), скорость, температура, скорость подачи эмульсии, тип полирующего движения, размер частиц эмульсии т.д.
В отличие от полировки кремниевых пластин, где количество удаляемого материала составляет 10 ± 0.1 мкм, при ХМП оксида кремния или металлов толщина удаляемого слоя составляет 0.5-1.0 ± 0.01 мкм. При проведении ХМП металлов требуется некоторая переполировка, для обеспечения полного удаления металла с плоских областей, при этом необходимо минимизировать потери оксида кремния.
| <== предыдущая страница | | | следующая страница ==> |
| Проблемы процесса сквозного травления резиста | | | Типы оборудования для ХМП |
Дата добавления: 2015-07-26; просмотров: 234; Нарушение авторских прав

Мы поможем в написании ваших работ!