
Главная страница Случайная лекция

Мы поможем в написании ваших работ!
Порталы:
БиологияВойнаГеографияИнформатикаИскусствоИсторияКультураЛингвистикаМатематикаМедицинаОхрана трудаПолитикаПравоПсихологияРелигияТехникаФизикаФилософияЭкономика

Мы поможем в написании ваших работ!
Растровая электронная микроскопия
Раздел посвящен изучению растровой электронной микроскопии. Здесь даны принцип работы, области применения метода при исследо-вании материалов. Рассмотрен микрорентгеноспектральный анализ ма-териалов. Получение информации об исследуемых объектах с помощью элек-тронного зонда возможно на основе физических явлений, возникающих при взаимодействии электронов с веществом объекта. При взаимодействии электронов с веществом, как показано на рисунке, по-является много вторичных излучений. Падающий электронный пучок может быть поглощен, упруго рассеян, может пройти через вещество, испытав при этом дифракцию, возбудить рентгеновское излучение, вы-звать появление низкоэнергетичных вторичных и Оже-электронов.
Принцип работы РЭМ основан на движении тонкого электронного луча (зонда) вдоль поверхности образца вдоль близко расположенных друг к другу линий, образующих растр. Способ получение изображения во вторичных электронах в РЭМ является наиболее распространенным. Сам процесс формирования изо-бражения в растровом микроскопе подобен процессу формирования оп-тического изображения, видимого в оптическом микроскопе. Это обу-словливает сходство по внешнему виду изображений, полученных в РЭМе, и в оптическом микроскопе. Следует отметить, что световые лу-чи, формирующие изображение, распространяются по прямым линиям, в то время как вторичные электроны могут достигать детектора по искривленным траекториям. Таким образом, для формирования изображе-ния в РЭМе важны не пути электронов к детектору, а только количество электронов, попадающих на детектор от данной точки объекта.
Наряду с прикладным значением Э. м. является самостоятельным научным направлением, предмет и цели которого включают: усовершенствование и разработку новых МЭ и других корпускулярных микроскопов (например, протонного микроскопа) и приставок к ним; разработку методик препарирования образцов, исследуемых в МЭ; изучение механизмов формирования электроннооптических изображений; разработку способов анализа разнообразной информации (не только изображений), получаемой с помощью МЭ.
Объекты исследований в Э. м. — большей частью твёрдые тела. В просвечивающих МЭ (ПЭМ), в которых электроны с энергиями от 1 кэв до 5 Мэв проходят сквозь объект, изучаются образцы в виде тонких плёнок, фольги (рис. 8), срезов и т. п. толщиной от 1 нм до 10 мкм. Поверхностную и приповерхностную структуру массивных тел с толщиной существенно больше 1 мкм исследуют с помощью непросвечивающих МЭ: растровых (РЭМ) (рис. 9), зеркальных, ионных проекторов и электронных проекторов.
Можно изучать порошки, микрокристаллы, частицы аэрозолей и т. д., нанесённые на подложку: тонкую плёнку для исследования в ПЭМ или массивную подложку для исследования в РЭМ. Поверхностная геометрическая структура массивных тел изучается и методом реплик: с поверхности такого тела снимается отпечаток в виде тонкой плёнки углерода, коллодия, формвара и др., повторяющий рельеф поверхности и рассматриваемый в ПЭМ. Обычно предварительно на реплику в вакууме напыляется под скользящим (малым к поверхности) углом слой сильно рассеивающего электроны тяжёлого металла (например, Pt), оттеняющего выступы и впадины геометрического рельефа. При исследовании методом так называемого декорирования не только геометрической структуры поверхностей, но и микрополей, обусловленных наличием дислокаций (рис. 10), скоплений точечных дефектов, ступеней роста кристаллических граней, доменной структуры и т. д., на поверхность образца вначале напыляется очень тонкий слой декорирующих частиц (атомы Au, Pt и др., молекулы полупроводников или диэлектриков), осаждающихся преимущественно на участках сосредоточения микрополей, а затем снимается реплика с включениями декорирующих частиц.
Специальные газовые микрокамеры — приставки к ПЭМ или РЭМ — позволяют изучать жидкие и газообразные объекты, неустойчивые к воздействию высокого вакуума, в том числе влажные биологические препараты. Радиационное воздействие облучающего электронного пучка довольно велико, поэтому при исследовании биологических, полупроводниковых, полимерных и т. п. объектов необходимо тщательно выбирать режим работы МЭ, обеспечивающий минимальную дозу облучения.
Наряду с исследованием статическим, не меняющихся во времени объектов Э. м. даёт возможность изучать различные процессы в динамике их развития: рост плёнок, деформацию кристаллов под действием переменной нагрузки, изменение структуры под влиянием электронного или ионного облучения и т. д. (исследования «in situ»). Вследствие малой инерционности электрона можно исследовать периодические во времени процессы, например перемагничивание тонких магнитных плёнок, переполяризацию сегнетоэлектриков, распространение ультразвуковых волн и т. д., методами стробоскопической Э. м.: электронный пучок «освещает» образец импульсами, синхронными с подачей импульсного напряжения на образец, что обеспечивает фиксацию на экране прибора определенной фазы процесса точно так же, как это происходит в светооптических стробоскопических приборах (рис. 11). Предельное временное разрешение при этом может, в принципе, составлять около 10-15 сек для ПЭМ (практически реализовано разрешение Электронная микроскопия 10-10 сек для ПЭМ и РЭМ).
Для интерпретации изображений аморфных и других тел (размеры частиц которых меньше разрешаемого в МЭ расстояния), рассеивающих электроны диффузно, используются простейшие методы амплитудной Э. м. Например, в ПЭМ контраст изображения, т. е. перепад яркостей изображения соседних участков объекта, в первом приближении пропорционален перепаду толщин этих участков. Для расчёта контраста изображений кристаллических тел (рис. 12), имеющих регулярные структуры (при рассеянии частиц на таких телах происходит дифракция частиц, и решения обратной задачи — расчёта структуры объекта по наблюдаемому изображению — привлекаются методы фазовой Э. м.: решается задача о дифракции электронной волны на кристаллической решетке. При этом дополнительно учитываются неупругие взаимодействия электронов с объектом: рассеяние на плазмах, фононах и т. п. В ПЭМ и растровых ПЭМ (ПРЭМ) высокого разрешения получают изображения отдельных молекул или атомов тяжелых элементов; пользуясь методами фазовой Э. м., восстанавливают по изображениям трехмерную структуру кристаллов и биологических макромолекул. Для решения подобных задач применяют, в частности, методы голографии, а расчеты производят на ЭВМ.
Разновидность фазовой Э. м. — интерференционная Э. м., аналогичная оптической интерферометрии: электронный пучок расщепляется с помощью электронных призм, и в одном из плеч интерферометра устанавливается образец, изменяющий фазу проходящей сквозь него электронной волн. Этим методом можно измерить, например, внутренний электрический потенциал образца.
С помощью лоренцовой Э. м., в которой изучают явления, обусловленные силой Лоренца, исследуют внутренние магнитные и электрические поля или внешние поля рассеяния, например поля магнитных доменов в тонких пленках (рис. 13), сегнетоэлектрических доменов, поля головок для магнитной записи информации и т. п.
Состав объектов исследуется методами микродифракции, т. е. электронографии локальных участков объекта, рентгеновского и катодолюминисцентного спектрального микроанализа: регистрируются характеристические рентгеновские спектры или катодолюминисцентное излучение, возникающее при бомбардировке образца сфокусированным пучком электронов (диаметр электронного «зонда» менее 1 мкм). Кроме того, изучаются энергетические спектры вторичных электронов, выбитых первичным электронным пучком с поверхности или из объема образца.
Интенсивно разрабатываются методы количественной Э. м. — точное измерение различных параметров образца или исследуемого процесса, например измерение локальных электрических потенциалов (рис. 14), магнитных полей (рис. 15), микрогеометрии поверхностного рельефа и т. д. МЭ используются и в технологических целях (например, для изготовления микросхем методом фотолитографии.
Литература.
1. Хокс П., Электронная оптика и электронная микроскопия, пер. с англ., М., 1974;
2. Стоянова И. Г., Анаскин И. Ф., Физические основы методов просвечивающей электронной микроскопии, М., 1972;
3. Утевский Л. М., Дифракционная электронная микроскопия в металловедении, М., 1973; 4. Электронная микроскопия тонких кристаллов, пер. с англ., М., 1968;
5. Спивак Г. В., Сапарин Г. В., Быков М. В., Растровая электронная микроскопия, «Успехи физических наук», 1969, т. 99, в. 4;
6. Вайнштейн Б. К., Восстановление пространственной структуры биологических объектов по электронным микрофотографиям, «Изв. АН СССР. Сер. физическая», 1972, т. 36, № 9;
7. Quantitftive scanning electron microscopy, L. — N. Y. — S. F., 1974.
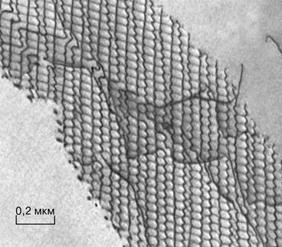
Рис. 8. Полученное в просвечивающем электронном микроскопе изображение сетки дислокаций на границах зёрен в тонкой молибденовой фольге, деформированной при высокотемпературном нагреве.

Рис. 9. Изображение предварительно отполированной, а затем подвергнутой ионной бомбардировке поверхности монокристалла меди. Снято в растровом электронном микроскопе. Увеличение 3000.

Рис. 10. Винтовые дислокации на поверхности кристалла NaCl, подвергнутого термическому травлению при температуре 500 °С. Изображение получено методом декорирования.
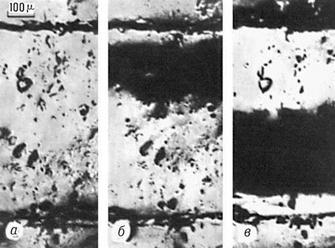
Рис. 11. Изображения поверхности кремниевого полупроводникового диода, полученные в стробоскопическом эмиссионном электронном микроскопе: а — напряжение на диоде отсутствует; б — на диод подано запирающее напряжение 40 в, появившаяся тёмная область — падение напряжения на р — n-переходе; в — кратковременное (менее 40 нсек) прямое падение напряжения (широкая тёмная область) на базе диода при переключении его в состояние, при котором он «отперт».

Рис. 12. Изображение атомной решётки плёнки золота. Расстояние между кристаллографическими плоскостями 2,04 Å. Снято в просвечивающем электронном микроскопе ЭМВ-100Л при электроннооптическом увеличении 350000 с последующим оптическим увеличением снимка.

Рис. 13. Изображение доменной структуры тонкой однородной по толщине пермаллоевой плёнки. Снято в просвечивающем электронном микроскопе при дефокусировке изображения (метод лоренцевой электронной микроскопии). Светлые и тёмные узкие полосы — границы доменов. Видна «рябь» намагниченности, возникающая вследствие малых изменений направлений векторов намагниченности (отмечены стрелками) внутри доменов.
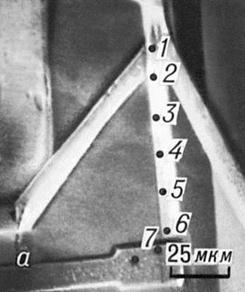
Рис. 14. Полученное с помощью растрового электронного микроскопа изображение участка интегральной микросхемы.

Рис. 15. Изображение линий равной напряженности поля (от 25 до 150 гс через 25 гс) над зазором магнитной головки (ширина зазора 2δ = 2 мкм) для магнитной записи информации. Получено в растровом электронном микроскопе со специальной приставкой.
| <== предыдущая страница | | | следующая страница ==> |
| Электронная микроскопия. Чтобы понять поведение материалов и об-легчить задачу создания новых материалов или материалов с улучшен-ными свойствами | | | Нейтронография |
Дата добавления: 2014-05-20; просмотров: 1147; Нарушение авторских прав

Мы поможем в написании ваших работ!